SMT-k soldadura-pasta konbentzionala erabiltzen du aireztapen bidezko soldadura-barrunbeen analisia eta irtenbidea (2023 Essence Edition), merezi duzu!
1 Sarrera

Zirkuitu-plakaren muntaketan, soldadura-pasta zirkuitu-plakaren soldadura-plakan inprimatzen da lehenik, eta ondoren hainbat osagai elektroniko itsasten dira. Azkenik, birfluxu-labearen ondoren, soldadura-pastako eztainu-aleak urtzen dira eta mota guztietako osagai elektronikoak eta zirkuitu-plakaren soldadura-plaka elkarrekin soldatzen dira azpimodulu elektrikoen muntaketa gauzatzeko. Gainazaleko muntaketa-teknologia (SMT) gero eta gehiago erabiltzen da dentsitate handiko ontziratze-produktuetan, hala nola sistema-mailako paketeetan (SiP), ballgridarray (BGA) gailuetan eta potentzia-txipa biluzian, pin gabeko pakete karratu lauan (quad aatNo-lead, QFN bezala ezagutzen dena) gailuetan.
Soldadura-pasta soldadura prozesuaren eta materialen ezaugarriak direla eta, gainazal handiko soldadura-gailu hauen birsoldaketaren ondoren, zuloak egongo dira soldadura-eremuan, eta horrek produktuaren errendimenduaren propietate elektrikoetan, propietate termikoetan eta propietate mekanikoetan eragina izango du, eta baita produktuaren matxura ere eragingo du. Beraz, soldadura-pasta birsoldaketaren barrunbea hobetzea konpondu beharreko prozesu eta arazo tekniko bihurtu da. Ikerlari batzuek BGA soldadura-bola soldadura barrunbearen arrazoiak aztertu eta aztertu dituzte, eta hobekuntza-irtenbideak eman dituzte. Ohiko soldadura-pasta birsoldaketaren prozesuko 10 mm2-tik gorako QFN soldadura-eremua edo 6 mm2-tik gorako soldadura-eremua txip biluziaren irtenbidea falta da.
Erabili Preformsolder soldadura eta hutsean errefluxu labeko soldadura soldadura soldadura zuloak hobetzeko. Aurrefabrikatutako soldadurak ekipamendu berezia behar du fluxua puntuan jartzeko. Adibidez, txipa nabarmen desbideratu eta okertu egiten da zuzenean aurrefabrikatutako soldaduraren gainean jarri ondoren. Fluxu muntaketa txipa birfluxuz eta gero puntuan jartzen bada, prozesua bi birfluxuz handitzen da, eta aurrefabrikatutako soldaduraren eta fluxu materialaren kostua soldadura pastarena baino askoz handiagoa da.
Hutsean errefluxu ekipoa garestiagoa da, hutsean dagoen ganbera independentearen hutsune-ahalmena oso baxua da, kostu-errendimendua ez da altua, eta eztainu-zipriztinen arazoa larria da, eta hori faktore garrantzitsua da dentsitate handiko eta urrats txikiko produktuak aplikatzeko. Lan honetan, soldadura-pasta birfluxu bidezko soldadura-prozesu konbentzionalean oinarrituta, bigarren mailako birfluxu bidezko soldadura-prozesu berri bat garatu eta aurkezten da soldadura-barrunbea hobetzeko eta soldadura-barrunbeak eragindako lotura- eta plastikozko zigilu-hausturen arazoak konpontzeko.
2 Soldadura-pasta inprimatzeko birfluxu bidezko soldadura-barrunbea eta ekoizpen-mekanismoa
2.1 Soldadura-barrunbea
Birsoldaketaren ondoren, produktua X izpien bidez probatu zen. Kolore argiagoa zuten soldadura-eremuko zuloak soldadura-geruzan soldadura nahikorik ez zegoelako zirela ikusi zen, 1. irudian ikusten den bezala.
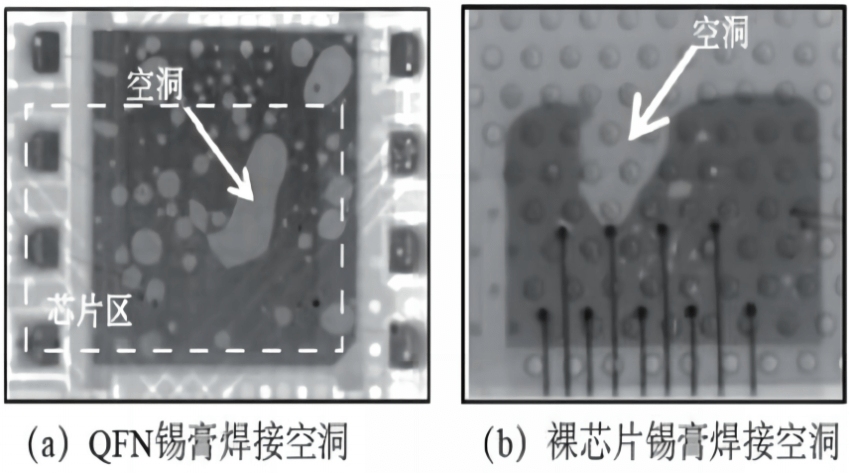
Burbuila-zuloaren X izpien detekzioa
2.2 Soldadura-barrunbearen eraketa-mekanismoa
sAC305 soldadura-pasta adibide gisa hartuta, konposizio eta funtzio nagusiak 1. taulan ageri dira. Fluxua eta eztainu-aleak pasta forman lotuta daude. Eztainu-soldaduraren eta fluxuaren arteko pisu-erlazioa 9:1 ingurukoa da, eta bolumen-erlazioa 1:1 ingurukoa.

Soldadura-pasta inprimatu eta hainbat osagai elektronikorekin muntatu ondoren, soldadura-pastak lau etapa igaroko ditu: aurreberotzea, aktibazioa, errefluxua eta hoztea, errefluxu-labetik igarotzean. Soldadura-pastaren egoera ere desberdina da tenperatura desberdinekin etapa desberdinetan, 2. irudian erakusten den bezala.
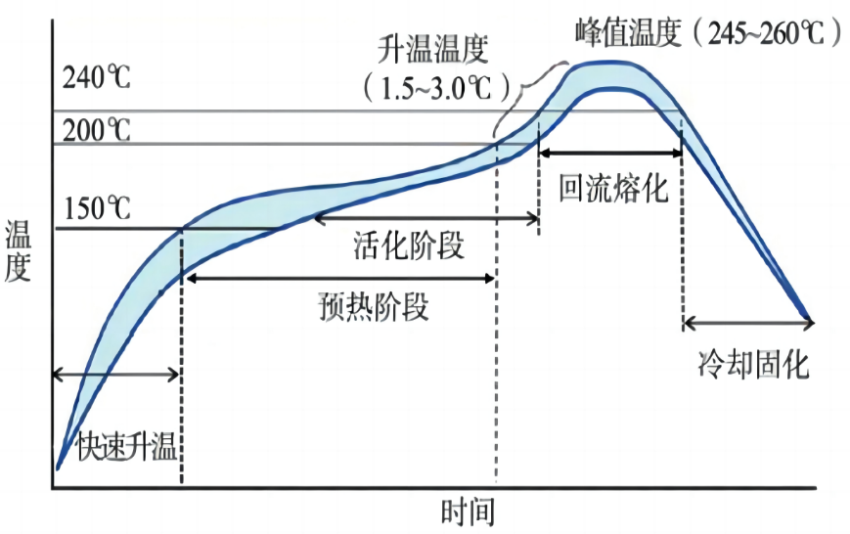
Errefluxu bidezko soldaduraren eremu bakoitzerako erreferentzia-profila
Aurreberotze eta aktibazio fasean, soldadura-pastako fluxuan dauden osagai lurrunkorrak gas bihurtuko dira berotzean. Aldi berean, gasak sortuko dira soldadura-geruzaren gainazaleko oxidoa kentzean. Gas horietako batzuk lurrundu eta soldadura-pastatik aterako dira, eta soldadura-aleak oso kondentsatu egingo dira fluxuaren lurruntzearen ondorioz. Errefluxu fasean, soldadura-pastako gainerako fluxua azkar lurrunduko da, eztainu-aleak urtuko dira, fluxu-gas lurrunkor kantitate txiki bat eta eztainu-aleen arteko aire gehiena ez dira denboran barreiatuko, eta eztainu urtuan eta eztainu urtuaren tentsiopean dauden hondarrak hanburgesa-sandwich egitura dira eta zirkuitu-plakaren soldadura-plakak eta osagai elektronikoek harrapatzen dituzte, eta eztainu likidoan bildutako gasa zaila da ateratzen goranzko flotagarritasunagatik bakarrik. Goiko urtze-denbora oso laburra da. Eztainu urtua hozten denean eta eztainu solido bihurtzen denean, poroak agertzen dira soldadura-geruzan eta soldadura-zuloak sortzen dira, 3. irudian ikusten den bezala.
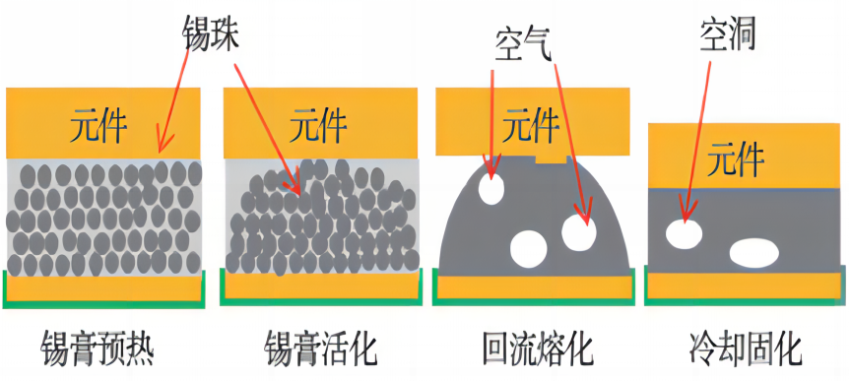
Soldadura-pasta birfluxu bidezko soldadurak sortutako hutsunearen eskema-diagrama
Soldatzeko barrunbearen erroko kausa soldadura-pastaren barruan urtu ondoren bildutako airea edo gas lurrunkorra ez dela guztiz askatzen da. Eragileen artean daude soldadura-pastaren materiala, soldadura-pastaren inprimaketaren forma, soldadura-pastaren inprimaketaren kantitatea, errefluxu-tenperatura, errefluxu-denbora, soldadura-tamaina, egitura eta abar.
3. Soldadura-pasta inprimatzeko birfluxu bidezko soldadura-zuloen eragin-faktoreen egiaztapena
QFN eta txip biluziko probak erabili ziren birfluxu soldadurako hutsuneen arrazoi nagusiak berresteko, eta soldadura-pastak inprimatutako birfluxu soldadurako hutsuneak hobetzeko moduak aurkitzeko. QFN eta txip biluziko soldadura-pastaren birfluxu soldadura produktuaren profila 4. irudian ageri da, QFN soldadura gainazalaren tamaina 4.4mmx4.1mm da, soldadura gainazala eztainuzko geruza da (% 100 eztainu purua); Txip biluziaren soldadura tamaina 3.0mmx2.3mm da, soldadura geruza nikel-vanadio bimetaliko geruza ihinztatua da, eta gainazaleko geruza vanadioa da. Substratuaren soldadura-plaka nikel-paladio urrez murgilduta zegoen, eta lodiera 0.4μm/0.06μm/0.04μm zen. SAC305 soldadura-pasta erabili zen, soldadura-pasta inprimatzeko ekipoa DEK Horizon APix da, errefluxu-labeko ekipoa BTUPyramax150N da eta X izpien ekipoa DAGExD7500VR da.
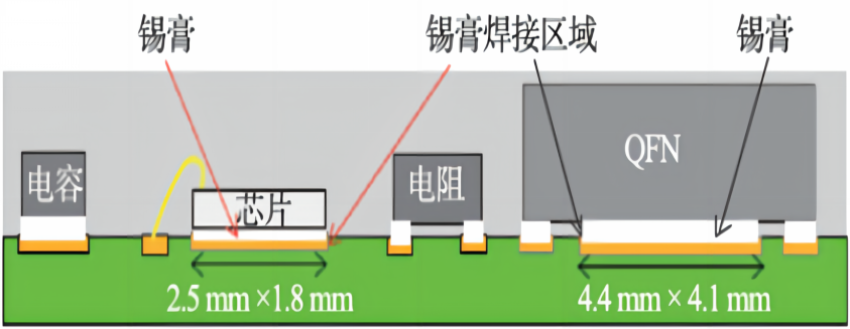
QFN eta txirbil biluziko soldadura marrazkiak
Proben emaitzen alderaketa errazteko, birfluxuzko soldadura 2. taulan agertzen diren baldintzetan egin zen.

Birfluxu soldadura baldintzen taula
Gainazaleko muntaketa eta birfluxu bidezko soldadura amaitu ondoren, soldadura geruza X izpien bidez detektatu zen, eta QFNren beheko aldean eta txiparen beheko aldean soldadura geruzan zulo handiak zeudela ikusi zen, 5. irudian ikusten den bezala.
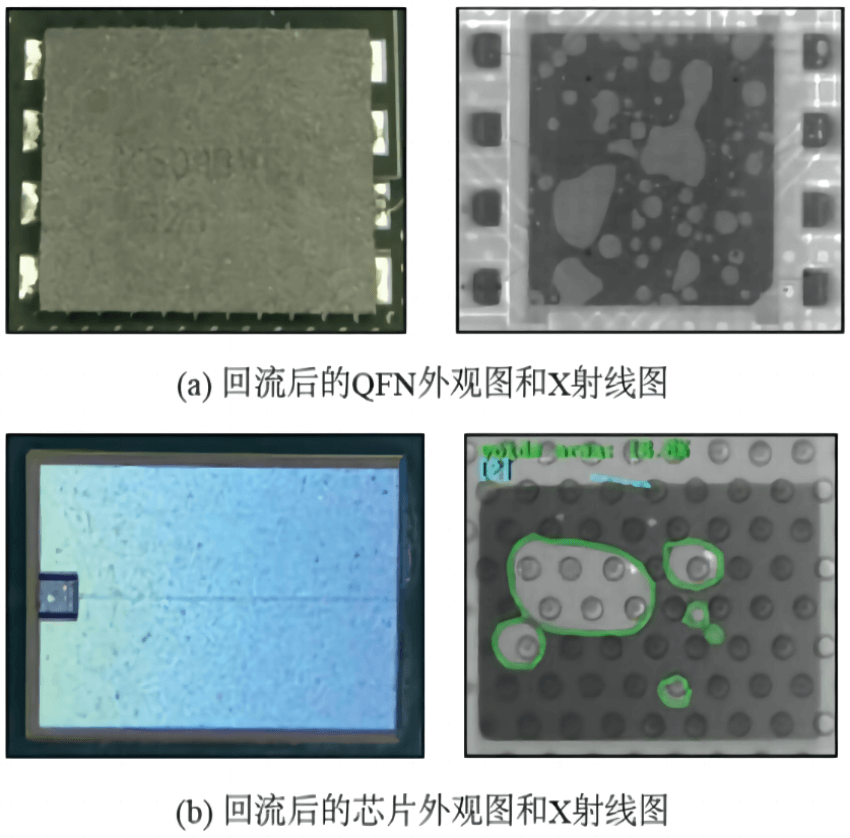
QFN eta Txip Holograma (X izpien bidez)
Eztainu-aleen tamainak, altzairuzko sarearen lodierak, irekidura-eremuaren abiadurak, altzairuzko sarearen formak, errefluxu-denborak eta labearen tenperatura maximoak birfluxu-soldadurako hutsuneetan eragina izango dutenez, eragin-faktore asko daude, DOE probaren bidez zuzenean egiaztatuko direnak, eta talde esperimentalen kopurua handiegia izango da. Beharrezkoa da eragin-faktore nagusiak azkar aztertzea eta zehaztea korrelazio-konparazio probaren bidez, eta gero eragin-faktore nagusiak DOE bidez optimizatzea.
3.1 Soldadura-zuloen eta soldadura-pasta eztainuzko aleen neurriak
3. motako (25-45 μm-ko alearen tamaina) SAC305 soldadura-pastaren probarekin, gainerako baldintzak aldatu gabe mantentzen dira. Birfluxuaren ondoren, soldadura-geruzaren zuloak neurtu eta 4. motako soldadura-pastarekin alderatu dira. Ikusi da soldadura-geruzaren zuloak ez direla nabarmen desberdinak bi soldadura-pasta moten artean, eta horrek adierazten du alearen tamaina desberdina duen soldadura-pastak ez duela eragin nabarmenik soldadura-geruzaren zuloetan, eta hori ez dela eragin-faktore bat, 6. irudian erakusten den bezala. Erakusten den bezala.

Eztainu metaliko hautsaren zuloen konparaketa partikula tamaina desberdinekin
3.2 Soldadura-barrunbearen eta altzairuzko sare inprimatuaren lodiera
Birfluxuaren ondoren, soldatutako geruzaren barrunbearen azalera 50 μm, 100 μm eta 125 μm-ko lodierako altzairuzko sare inprimatuarekin neurtu zen, eta gainerako baldintzak aldatu gabe mantendu ziren. Ikusi zen altzairuzko sarearen (soldadura-pasta) lodiera desberdinek QFN-n zuten eragina 75 μm-ko lodierako altzairuzko sare inprimatuarekin alderatu zela. Altzairuzko sarearen lodiera handitzen den heinean, barrunbearen azalera pixkanaka gutxitzen da. Lodiera jakin batera iritsi ondoren (100 μm), barrunbearen azalera alderantzikatu egingo da eta handitzen hasiko da altzairuzko sarearen lodiera handitzen den heinean, 7. irudian ikusten den bezala.
Honek erakusten du soldadura-pasta kantitatea handitzen denean, errefluxua duen eztainu likidoa txipak estaltzen duela, eta ihes egiten duen aire hondarraren irteera lau aldeetatik bakarrik estutzen dela. Soldadura-pasta kantitatea aldatzen denean, ihes egiten duen aire hondarraren irteera ere handitzen da, eta eztainu likidoan edo ihes egiten duen eztainu likidoan bildutako aire-leherketa berehalakoak eztainu likidoa QFNaren eta txiparen inguruan zipriztintzea eragingo du.
Probak aurkitu zuen altzairuzko sarearen lodiera handitzen den heinean, airearen edo gas lurrunkorraren ihesak eragindako burbuila-leherketak ere handituko direla, eta QFNren eta txirbilaren inguruan eztainua zipriztintzeko probabilitatea ere handituko dela horren arabera.

Lodiera desberdineko altzairuzko sareko zuloen konparaketa
3.3 Soldadura-barrunbearen eta altzairuzko sarearen irekiduraren azalera-erlazioa
% 100, % 90 eta % 80ko irekitze-tasa zuen altzairuzko sare inprimatua probatu zen, eta gainerako baldintzak aldatu gabe mantendu ziren. Birfluxuaren ondoren, soldatutako geruzaren barrunbearen azalera neurtu eta % 100eko irekitze-tasa zuen altzairuzko sare inprimatuarekin alderatu zen. Ikusi zen ez zegoela alde handirik soldatutako geruzaren barrunbean % 100eko eta % 90-% 80ko irekitze-tasa baldintzetan, 8. irudian ikusten den bezala.

Altzairuzko sare ezberdinen irekidura-azalera desberdinen barrunbeen konparaketa
3.4 Soldatutako barrunbea eta inprimatutako altzairuzko sarearen forma
B zerrendako soldadura-pastaren eta c sare inklinatuaren inprimatze-formaren probarekin, gainerako baldintzak aldatu gabe mantentzen dira. Birfluxuaren ondoren, soldadura-geruzaren barrunbearen azalera neurtu eta a sarearen inprimatze-formarekin alderatu da. Ikusi da ez dagoela alde nabarmenik soldadura-geruzaren barrunbean sarearen, zerrendaren eta sare inklinatuaren baldintzetan, 9. irudian erakusten den bezala.
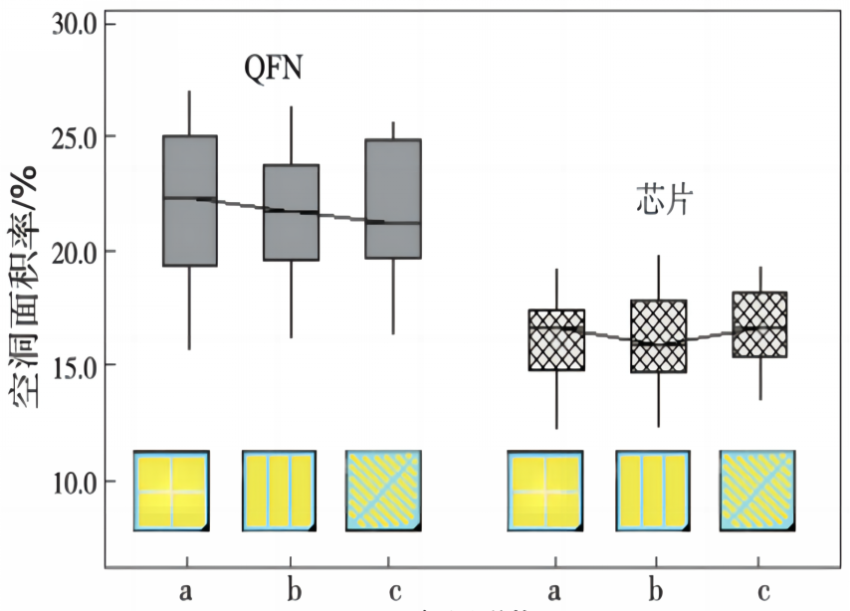
Altzairuzko sarearen irekiera modu desberdinetako zuloen konparaketa
3.5 Soldadura-barrunbea eta errefluxu-denbora
Errefluxu denbora luzez (70 s, 80 s, 90 s) egindako probaren ondoren, gainerako baldintzak aldatu gabe jarraitzen dute. Soldadura geruzaren zuloa neurtu zen errefluxuaren ondoren, eta 60 s-ko errefluxu denborarekin alderatuta, ikusi zen errefluxu denbora handitu ahala soldadura zuloaren azalera gutxitu egiten zela, baina murrizketa anplitudea pixkanaka gutxitu egiten zela denbora handitu ahala, 10. irudian erakusten den bezala. Horrek erakusten du errefluxu denbora nahikoa ez bada, errefluxu denbora handitzeak eztainu likido urtuan bildutako airearen gainezkatze osoa eragiten duela, baina errefluxu denbora denbora jakin batera igo ondoren, eztainu likidoan bildutako airea zaila dela berriro gainezka egitea. Errefluxu denbora soldadura barrunbean eragina duten faktoreetako bat da.

Errefluxu denbora-luzera desberdinen hutsune-konparaketa
3.6 Soldadura-barrunbea eta labearen tenperatura maximoa
240 ℃ eta 250 ℃-ko labearen tenperatura maximoaren probak eta beste baldintzak aldatu gabe, soldatutako geruzaren barrunbearen azalera neurtu zen birfluxuaren ondoren, eta 260 ℃-ko labearen tenperatura maximoarekin alderatuta, ikusi zen labearen tenperatura maximoaren baldintza desberdinetan QFN eta txiparen soldatutako geruzaren barrunbea ez zela nabarmen aldatu, 11. irudian erakusten den bezala. Horrek erakusten du labearen tenperatura maximo desberdinak ez duela eragin nabarmenik QFN-n eta txiparen soldadura geruzaren zuloan, eta hori ez dela eragin-faktore bat.

Tenperatura goren desberdinen konparaketa hutsala
Goiko probek adierazten dute QFNren soldadura geruzaren barrunbean eta txirbilaren gainean eragina duten faktore esanguratsuak errefluxu-denbora eta altzairuzko sarearen lodiera direla.
4 Soldadura-pasta inprimatzeko birfluxu bidezko soldadura-barrunbearen hobekuntza
4.1DOE proba soldadura-barrunbea hobetzeko
QFN eta txiparen soldadura geruzan dagoen zuloa hobetu zen eragin-faktore nagusien (errefluxu-denbora eta altzairuzko sarearen lodiera) balio optimoa aurkituz. Soldadura-pasta SAC305 4 motakoa zen, altzairuzko sarearen forma sareta motakoa zen (% 100eko irekiera-gradua), labearen tenperatura maximoa 260 ℃ izan zen, eta gainerako proba-baldintzak proba-ekipoaren berdinak izan ziren. DOE proba eta emaitzak 3. taulan ageri dira. Altzairuzko sarearen lodierak eta errefluxu-denborak QFN eta txiparen soldadura-zuloetan duten eragina 12. irudian ageri da. Eragin-faktore nagusien elkarrekintza-analisiaren bidez, ikusi da 100 μm-ko altzairuzko sarearen lodiera eta 80 segundoko errefluxu-denbora erabiltzeak QFN eta txiparen soldadura-barrunbea nabarmen murriztu dezakeela. QFNren soldadura-barrunbearen tasa gehienezko % 27,8tik % 16,1era murriztu da, eta txiparen soldadura-barrunbearen tasa gehienezko % 20,5etik % 14,5era murriztu da.
Proban, 1000 produktu ekoitzi ziren baldintza optimoetan (100 μm-ko altzairuzko sarearen lodiera, 80 s-ko errefluxu denbora), eta 100 QFN-ren eta txirbilaren soldadura-barrunbe-tasa ausaz neurtu zen. QFN-ren batez besteko soldadura-barrunbe-tasa % 16,4 izan zen, eta txirbilaren batez besteko soldadura-barrunbe-tasa % 14,7. Txirbilaren eta txirbilaren soldadura-barrunbe-tasa nabarmen murriztu zen.

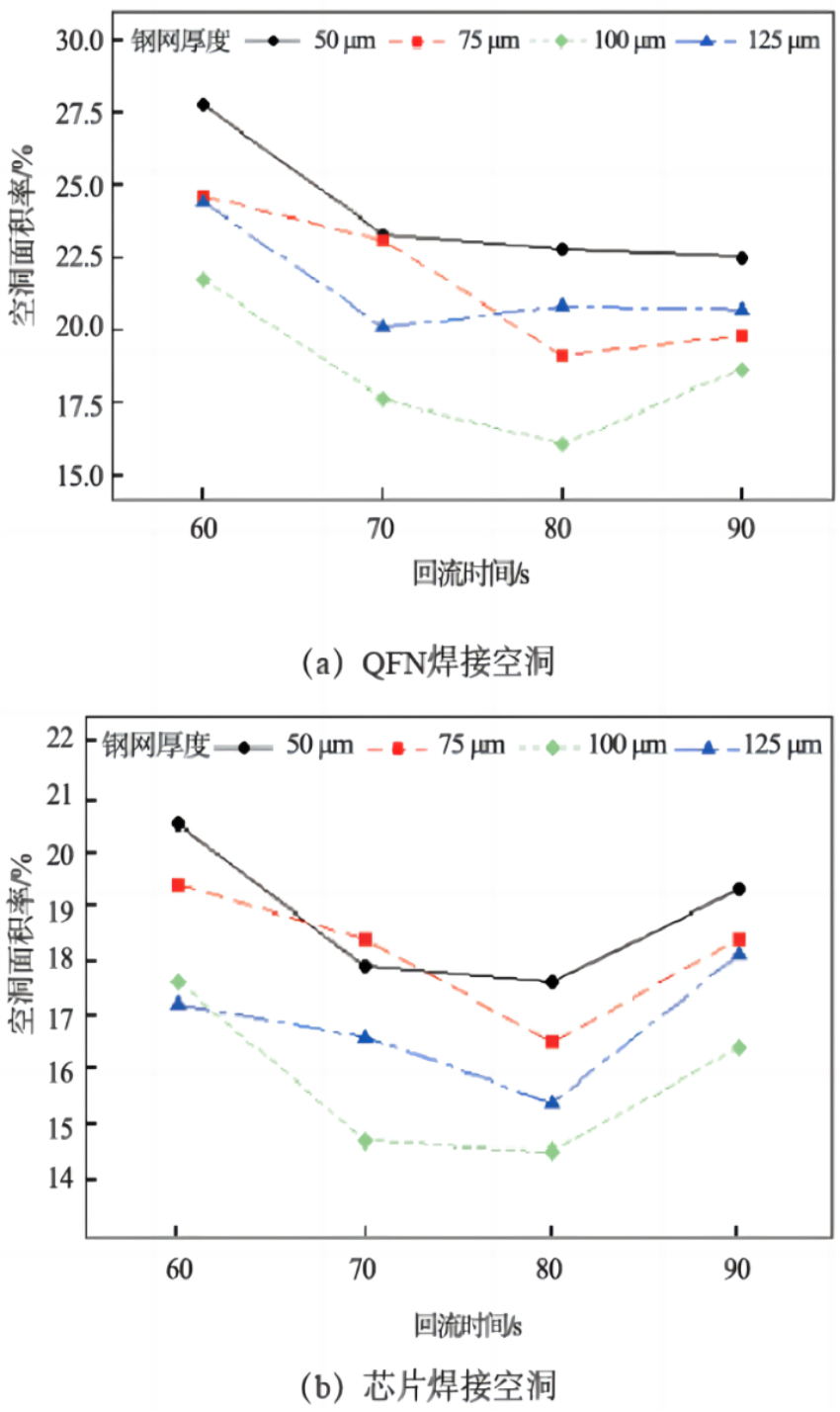
4.2 Prozesu berriak soldadura-barrunbea hobetzen du
Benetako ekoizpen-egoerak eta probek erakusten dute txiparen beheko soldadura-barrunbearen azalera % 10 baino txikiagoa denean, txiparen barrunbearen posizioko pitzadura-arazorik ez dela gertatuko berunezko lotura eta moldekatzean. DOE-k optimizatutako prozesu-parametroek ezin dituzte bete ohiko soldadura-pasta birfluxu bidezko soldaduran zuloak aztertu eta konpontzeko eskakizunak, eta txiparen soldadura-barrunbearen azalera-tasa gehiago murriztu behar da.
Soldadurak estalitako txipak soldadurako gasa ihes egitea eragozten duenez, txiparen beheko zulo-tasa are gehiago murrizten da soldaduraz estalitako gasa ezabatuz edo murriztuz. Bi soldadura-pasta inprimatzeko birfluxu-soldadura prozesu berri bat erabiltzen da: soldadura-pasta inprimaketa bat, QFN estaltzen ez duen birfluxu bat eta soldadurako gasa isurtzen duen txip biluzik; Bigarren mailako soldadura-pasta inprimaketaren, adabakiaren eta bigarren mailako errefluxuaren prozesu espezifikoa 13. irudian ageri da.
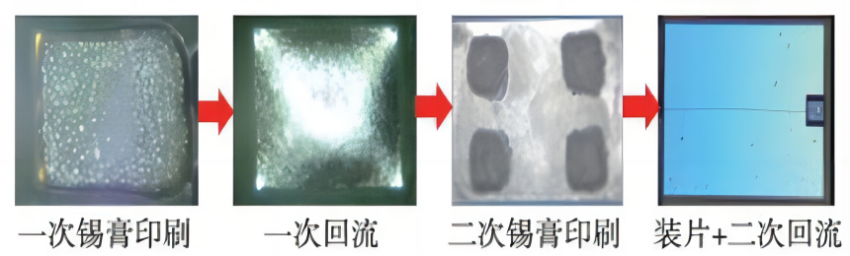
75 μm-ko lodierako soldadura-pasta lehen aldiz inprimatzen denean, txiparen estalkirik gabeko soldaduran dagoen gas gehiena gainazaletik ihes egiten du, eta errefluxuaren ondorengo lodiera 50 μm ingurukoa da. Lehen errefluxua amaitu ondoren, karratu txikiak inprimatzen dira hoztutako soldadura solidotuaren gainazalean (soldadura-pastaren kopurua murrizteko, gas-isuriaren kopurua murrizteko, soldadura-zipriztinak murrizteko edo ezabatzeko), eta 50 μm-ko lodierako soldadura-pasta (goiko proben emaitzek erakusten dute 100 μm dela onena, beraz, bigarren inprimaketaren lodiera 100 μm da. 50 μm = 50 μm), ondoren txipa instalatu eta 80 segundoz itzuli. Ia ez dago zulorik soldaduran lehen inprimaketaren eta birfluxuaren ondoren, eta bigarren inprimaketako soldadura-pasta txikia da, eta soldadura-zuloa txikia da, 14. irudian erakusten den bezala.
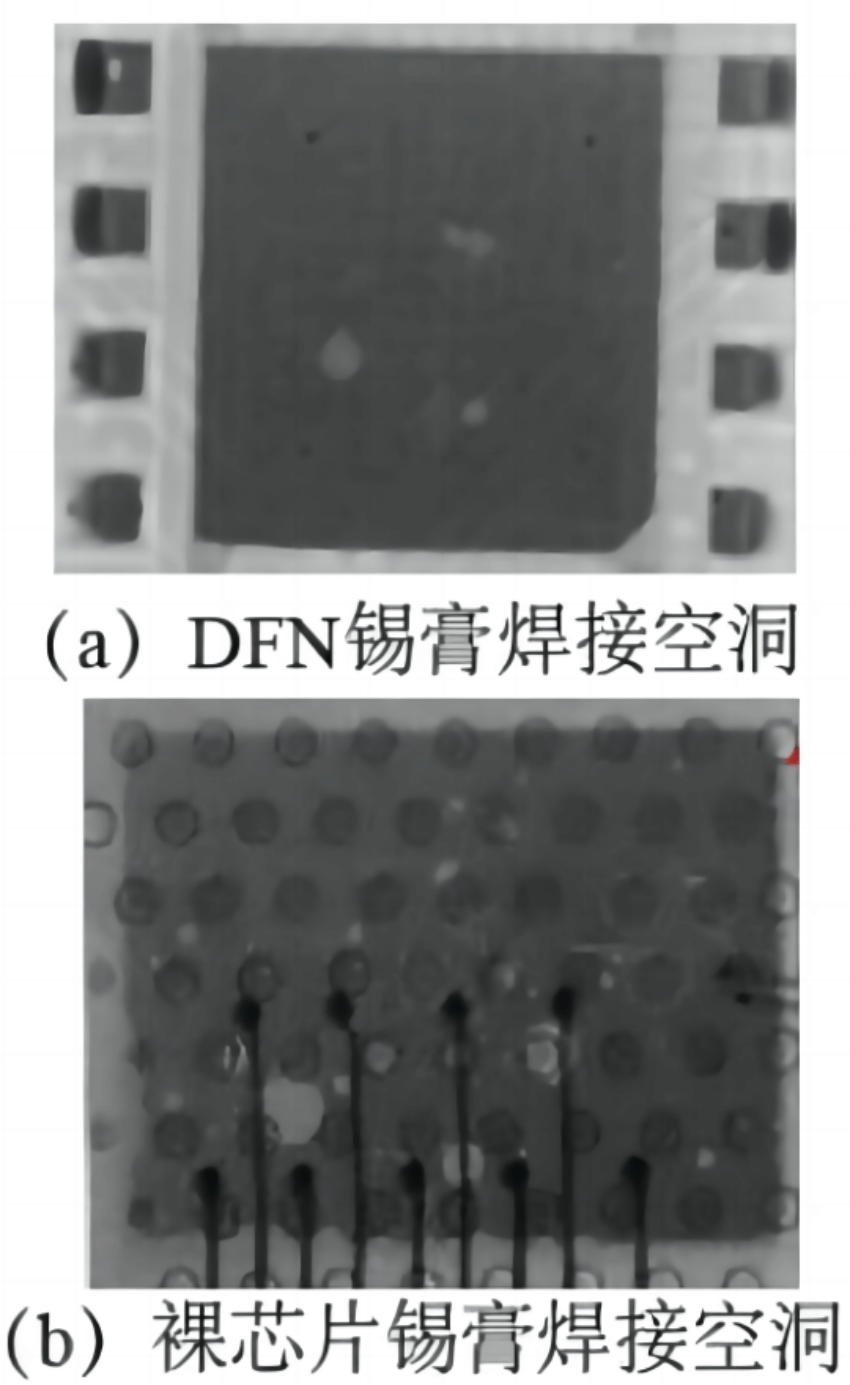
Soldatzeko pasta bi inprimatu ondoren, marrazki hutsa
4.3 Soldadura-barrunbearen efektuaren egiaztapena
2000 produktu ekoiztu ziren (lehenengo inprimatzeko altzairuzko sarearen lodiera 75 μm-koa da, bigarren inprimatzeko altzairuzko sarearen lodiera 50 μm-koa), beste baldintzak aldatu gabe, 500 QFN-ren eta txiparen soldadura-barrunbe-tasaren ausazko neurketa eginez, ikusi zen prozesu berriak lehenengo errefluxuaren ondoren ez zuela barrunberik, bigarren errefluxu QFN-aren ondoren soldadura-barrunbe-tasa maximoa % 4,8koa zela, eta txiparen soldadura-barrunbe-tasa maximoa % 4,1ekoa. Jatorrizko pasta bakarreko inprimatzeko soldadura-prozesuarekin eta DOE optimizatutako prozesuarekin alderatuta, soldadura-barrunbea nabarmen murriztu zen, 15. irudian erakusten den bezala. Produktu guztien funtzionalitate-proben ondoren, ez zen txiparen pitzadurarik aurkitu.

5 Laburpena
Soldadura-pastaren inprimatze-kantitatearen eta errefluxu-denboraren optimizazioak soldadura-barrunbearen azalera murriztu dezake, baina soldadura-barrunbearen tasa oraindik handia da. Bi soldadura-pasta inprimatzeko birfluxu-soldadura teknika erabiltzeak soldadura-barrunbearen tasa eraginkortasunez maximizatu dezake. QFN zirkuituaren txip biluziaren soldadura-eremua 4,4 mm x 4,1 mm eta 3,0 mm x 2,3 mm izan daiteke, hurrenez hurren, masa-ekoizpenean. Birfluxu-soldaduraren barrunbe-tasa % 5etik behera kontrolatzen da, eta horrek birfluxu-soldaduraren kalitatea eta fidagarritasuna hobetzen ditu. Artikulu honetako ikerketak erreferentzia garrantzitsua eskaintzen du soldadura-azalera handiko soldadura-barrunbearen arazoa hobetzeko.






